芯片基板是承载芯片的重要载体,主要用来固定从晶圆切好的晶片,是芯片封装环节不可或缺的一部分。基板能固定的晶片越多,整个芯片的晶体管就越多,功能更多,性能更好。因此,如何在有限的尺寸容纳更多的晶体管就成为了整个行业不断探索的发展方向。
TGV玻璃通孔重塑先进封装格局的关键力量
当前最主流的芯片基板是有机材料基板,加工难度小,生产成本较低,在芯片封装领域已经被应用多年。随着全球算力需求升级,2.5D/3D、Chiplet等先进封装技术持续发展,对信号传输速度、功率传输效率、基板稳定性的要求也不断提高,传统有机材料基板已经不能满足高性能芯片的封装需求,玻璃基板成为未来先进封装发展的重要方向。
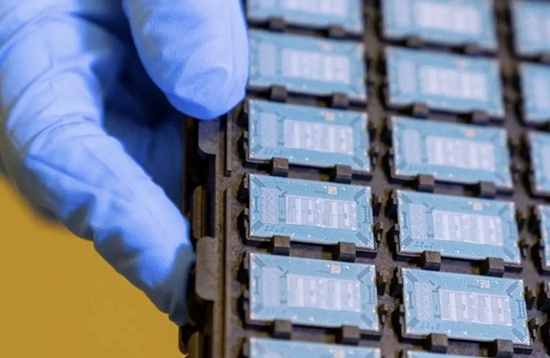
(图片来自网络)
相较于传统有机材料,玻璃基板在机械、物理、光学等方面都有显著优势。同时,玻璃材料还具备独特性能:
高平整度:玻璃材料独特的平整性质能够显著提高光刻的聚焦深度,从而大幅提升晶片间的互联密度;同面积玻璃基板上的开孔数量远超有机材料基板,玻璃通孔(TGV)之间的间隔能够小于100μm,直接让晶片之间的互连密度提升10倍;
耐高温:玻璃材料散热性好,极耐高温,而且与晶片的热膨胀系数相近,在高温下不易产生翘曲、断裂等形变问题,增加芯片可靠性;
低介电损耗:玻璃材料的电气性能十分优秀,有效降低信号传输过程中的功率损耗和能源消耗,从而极大增强了芯片的传输效率与计算能力,能显著提高芯片性能。

(图片来自网络)
玻璃通孔TGV(Through Glass Via)是一种先进的封装技术,它允许在玻璃基板上制造垂直互连的通道,从而实现设备小型化和三维集成,在高频电学特性、成本效益、机械稳定性以及应用领域等方面都具有显著优势。
TGV玻璃通孔技术的突破重新定义了先进封装市场格局,玻璃基板“换道超车”成为可能。
LIMHDE制孔掌握玻璃通孔核心技术
高质量、高密度的TGV通孔对中介层性能至关重要,但玻璃基板强度高、容易碎裂,如何快速制造具有高深宽比的玻璃深孔或沟槽成了各大厂商共同面对的难题。激光诱导微孔深度蚀刻技术脱颖而出,成为理想的解决方案。
激光诱导微孔深度蚀刻技术(LIMHDE制孔)是通过超快激光作用在玻璃材料表面,诱导玻璃产生连续变形区域,从而在化学刻蚀过程中创建盲孔和通孔的技术。
LIMHDE制孔技术效率高,精度高,作用范围精准,可实现高纵横/径厚比的微加工,并且微孔平滑、无微裂隙、无碎屑、无应力,不会在玻璃中产生多余的裂纹,是TGV通孔加工的绝佳选择。
华工激光自研创新引领行业新风向
作为中国激光工业化应用的开创者、引领者,华工激光多年来在透明硬脆材料加工领域具备丰富的行业应用经验、强大的自主创新实力与成熟的方案实施能力,打造了一批行业领先、国产替代、专精特新产品,并于2022年荣获国家级制造业单项冠军产品称号,赢得市场和客户的广泛认可。

面对玻璃基板的加工需求,华工激光自主开发了激光诱导微孔深度蚀刻技术(Laser Induced Micro Hole Deep Etching Technology,缩写LIMHDE)。该技术联合国际知名学府和国家级材料实验室共同开发,相比传统的玻璃穿孔技术,该技术拥有更好的穿孔质量、更小的加工半径和更深的加工深度。
该技术采用了最新一代超短脉冲激光技术,并针对玻璃、石英等不同类型的材料定制化开发了诱导微孔激光头,最小可以做到5μm孔径,径深比可达1:100。
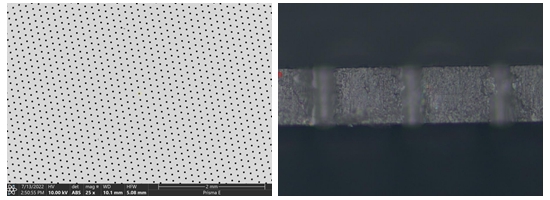
(样品加工效果)
目前该技术已经应用于玻璃基板加工领域,同时在多家客户现场进行工艺测试,能够为玻璃基板行业客户提供高效优质的先进封装解决方案。
华工激光准确洞察超快激光在先进封装领域中的发展潜力,精准聚焦TGV技术在高性能计算封装中的关键作用,紧跟半导体行业发展趋势,积极推进相关技术持续迭代升级,突破行业重点“卡脖子”难题,助力行业客户在AI发展浪潮中抢占发展先机,共同推动半导体先进封装技术的创新与发展。
关于华工激光
华工激光是中国激光工业化应用的开创者、引领者,全球激光加工解决方案权威提供商。我们全面布局激光智能装备、量测与自动化产线、智慧工厂建设,为智能制造提供整体解决方案。
我们深刻把握制造业发展趋势,不断丰富产品和解决方案,坚持探索自动化、信息化、智能化与制造业的融合,为各行业提供包括全功率系列的激光切割系统、激光焊接系统、激光打标系列、激光毛化成套设备、激光热处理系统、激光打孔机、激光器及各类配套器件、激光加工专用设备及等离子切割设备,及自动化产线、智慧工厂建设整体方案。